所谓光刻技术,指的是利用光化学反应原理把事先准备在掩模版上的图形转印到一个衬底(晶圆)上,使选择性的刻蚀和离子注入成为可能的过程,是半导体制造业的基础之一。随着半导体制造业的发展,光刻技术从曝光波长上来区分,先后经历了g线(436nm)、i线(365nm)、KrF(248nm)、ArF(193nm,包括干式和浸没式)和极紫外(EUV,13.5nm)光刻。对应于不同的曝光波长,所使用的光刻胶也得到了不断的发展。目前7nm和5nm技术节点已经到来,根据各个技术的芯片制造企业公告,EUV光刻技术已正式导入集成电路制造工艺。在每一代的光刻技术中,光刻胶都是实现光刻过程的关键材料之一。彩色光刻胶及黑色光刻胶市场也呈现日韩企业主导的格局,国内企业有雅克科技、飞凯材料、彤程新材等。浙江湿膜光刻胶光引发剂

由于早期制约EUV光刻发展的技术瓶颈之一是光源功率太小,因此,在不降低其他光刻性能的前提下提高EUV光刻胶的灵敏度一直是科研人员的工作重点。为了解决这一问题,2013年,大阪大学的Tagawa等提出了光敏化化学放大光刻胶(PSCAR™)。与其他EUV化学放大光刻胶不同的是,PSCAR体系除了需在掩模下进行产生图案的EUV曝光,还要在EUV曝光之后进行UV整片曝光。PSCAR体系中除了有主体材料、光致产酸剂,还包括光敏剂前体。这是一种模型光敏剂前体的结构,它本身对UV光没有吸收,但在酸性条件下可以转化为光敏剂,对UV光有吸收。江苏正性光刻胶单体光刻胶市场 ArF 与 KrF 占据主流,EUV 增长较快。
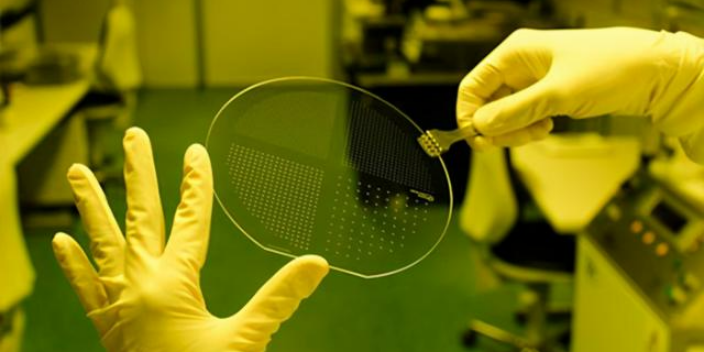
目前使用的ZEP光刻胶即采用了前一种策略。日本瑞翁公司开发的ZEP光刻胶起初用于电子束光刻,常用的商用品种ZEP520A为α-氯丙烯酸甲酯和α-甲基苯乙烯的1∶1共聚物。氯原子的引入可提高灵敏度,此外苯乙烯部分也可提高抗刻蚀性和玻璃化转变温度。采用后一种策略时,常用的高分子主链有聚碳酸酯和聚砜。2010年,美国纽约州立大学的课题组报道了一系列以聚碳酸酯高分子为主体材料的光刻胶,高分子主链中具有二级或三级烯丙酯结构可在酸催化下裂解形成双键和羧酸。此外,他们还在高分子中引入了芳香基团,以增强其抗刻蚀性。可获得36nm线宽、占空比为1∶1的线条,22.5mJ·cm−2的剂量下可获得线宽为26nm的线条。
2008年起,日本大阪府立大学的Okamura课题组利用聚对羟基苯乙烯衍生物来构造非化学放大型光刻胶。他们制备了对羟基苯乙烯单元和含有光敏基团的对磺酰胺苯乙烯单元的共聚物,作为光刻胶的主体材料。光照下,光敏剂产生自由基,使对羟基苯乙烯链之间发生交联反应,可作为EUV负性光刻胶使用。随后,他们又在对羟基苯乙烯高分子上修饰烯烃或炔烃基团,体系中加入多巯基化合物作为交联剂,以及光照下可以产生自由基的引发剂,构建了光引发硫醇-烯烃加成反应体系,该体系同样可以作为EUV负性光刻胶使用。值得指出的是,上述工作使用的对羟基苯乙烯衍生物的分子量均比较小,有助于提高光刻胶的分辨率。由于均为自由基反应,光刻过程的产气量也明显小于一般的光刻胶体系。在半导体集成电路制造行业:主要使用g线光刻胶、i线光刻胶、KrF光刻胶、ArF光刻胶等。

热压法能够有效增大光刻胶光栅的占宽比你,工艺简单、可靠,无需昂贵设备、成本低,获得的光栅质量高、均匀性好。将该方法应用到大宽度比的硅光栅的制作工艺中,硅光栅线条的高度比达到了12.6,氮化硅光栅掩模的占宽比更是高达0.72,光栅质量很高,线条粗细均匀、边缘光滑。值得注意的是,热压法通过直接展宽光刻胶光栅线条来增大占宽比,可以集成到全息光刻-离子束刻蚀等光栅制作工艺中,为光栅衍射效率的调节与均匀性修正提供了新思路。光刻胶行业的上下游合作处于互相依存的关系,市场新进入者很难与现有企业竞争,签约新客户的难度高。华东光刻胶单体
一旦达成合作,光刻胶厂商和下游集成电路制造商会形成长期合作关系。浙江湿膜光刻胶光引发剂
光刻胶的产业链上游:主要涉及溶剂、树脂、光敏剂等原材料供应商和光刻机、显影机、检测与测试等设备供应商。从原材料市场来看,由于中国从事光刻胶原材料研发及生产的供应商较少,中国光刻胶原材料市场主要被日本、韩国和美国厂商所占据。从设备市场来看,中国在光刻机、显影机、检测与测试设备行业的起步时间较晚,且这些设备具备较高的制造工艺壁垒,导致中国在光刻胶、显影机、检测与测试设备的国产化程度均低于10%。相信后期国产化程度会越来越高。浙江湿膜光刻胶光引发剂