全息光刻-单晶硅各向异性湿法刻蚀是制作大高度比硅光栅的一种重要且常用的方法,全息光刻用来产生光刻胶光栅图形,单晶硅各向异性湿法刻蚀将图形转移到硅基底中形成硅光栅。这种方法制作的硅光栅质量非常高,侧壁可以达到原子级光滑,光栅线条的高度比可以高达160。但由于单晶硅各向异性湿法刻蚀在垂直向下刻蚀的同时存在着横向钻蚀,所以要获得大高度比的硅光栅,光刻胶光栅图形的占宽比要足够大,且越大越好。占宽比越大,单晶硅各向异性湿法刻蚀的工艺宽容度越大,成功率越高,光栅质量越好。光刻胶又称光致抗蚀剂,是一种对光敏感的混合液体。上海干膜光刻胶显示面板材料

尽管高分子体系一直是前代光刻胶的发展路线,但随着光刻波长进展到EUV阶段,高分子体系的缺点逐渐显露出来。高分子化合物的分子量通常较大,链段容易发生纠缠,因此想要实现高分辨率、低粗糙度的光刻线条,必须降低分子量,从而减少分子体积。随着光刻线条越来越精细,光刻胶的使用者对光刻胶的性能要求也越来越高,其中重要的一条便是光刻胶的质量稳定性。由于高分子合成很难确保分子量分布为1,不同批次合成得到的主体材料都会有不同程度的成分差异,这就使得高分子光刻胶难以低成本地满足关键尺寸均一性等批次稳定性要求。嘉定彩色光刻胶光引发剂光刻胶的组成部分包括:光引发剂(包括光增感剂、光致产酸剂)、光刻胶树脂、单体、溶剂和其他助剂。

中国在光刻胶领域十分不利,虽然G线/I线光刻胶已经基本实现进口替代,但高级别光刻胶依然严重依赖进口。KrF/ArF光刻胶自给率不足5%,EUV光刻胶还只是“星星之火”。国产KrF光刻胶已经逐步实现国产替代并正在放量,ArF光刻胶也在逐步验证并实现销售当中,国产光刻胶已经驶入了快车道。随着下游产能的快速增长,国产KrF/ArF光刻胶的需求将会持续提升。众所周知,在半导体装置的制造过程中,用于各种电路的无缝电气连接金属布线随着半导体产品的高集成化、高速化,越来越要求以较小的线宽制作。因此,选择合适的光刻胶是非常重要的,随着金属布线的线宽变小,不单大功率和低压力被用作金属布线形成的蚀刻方法,根据所用光刻胶的特点,去除蚀刻进程中产生的聚合物和光刻胶是非常重要的。
20世纪七八十年代,我国光刻胶研发水平一直与国外持平。1977年,化学研究所曾出版了我国一部有关光刻胶的专著《光致抗蚀剂:光刻胶》。但随后的1990~2010年,由于缺乏芯片产业的牵引,我国光刻胶研发处于停滞状态。直到2010年后,我国才又开始重新组建光刻胶研发队伍。目前我国的EUV光刻胶主要集中在单分子树脂型和有机-无机杂化型,暂无传统高分子EUV光刻胶的相关工作见诸报道。我国开展EUV光刻胶研究的主要有化学研究所杨国强课题组和理化技术研究所李嫕课题组。产品纯度、金属离子杂质控制等也是光刻胶生产工艺中需面临的技术难关,光刻胶纯度不足会导致芯片良率下降。
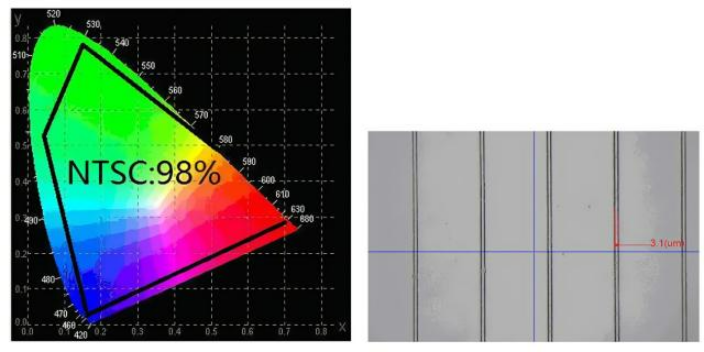
EUV光刻胶的基本原理与所有使用其他波长光曝光的光刻胶是相同的,都是在光照后发生光化学反应及热化学反应,主体材料结构改变导致光刻胶溶解度转变,从而可以被部分显影。但与其他波长曝光的光刻工艺相比,EUV光刻也有着诸多的不同。从化学反应机理来看,EUV光刻与前代光刻差异是,引发反应的,不仅有光子,还有由13.5nm软X射线激发出的二次电子。EUV光刻用到的光子能量高达92eV,曝光过程中,几乎所有的原子都能吸收EUV光子而发生电离,并产生高能量的二次电子(65~87eV)和空穴,二次电子可以继续激发光敏剂,形成活性物种。根据应用领域不同,光刻胶可分为 PCB 光刻胶、LCD 光刻胶和半导体光刻胶,技术门槛逐渐递增。嘉定i线光刻胶集成电路材料
国内光刻胶市场增速远高于全球,国内企业投入加大,未来有望实现技术赶超。上海干膜光刻胶显示面板材料
关于光刻胶膜对EUV光的吸收能力,研究人员的观点曾发生过较大的转变。刚开始研究人员认为光刻胶应对EUV尽量透明,以便EUV光可以顺利透过光刻胶膜。对于紫外、深紫外光刻来说,如果光子不能透过胶膜,则会降低光刻的对比度,即开始曝光剂量和完全曝光剂量之间存在较大的差值,从而使曝光边界处图案不够陡直。所以,早期的EUV光刻胶研发通常会在分子结构中引入Si、B等EUV吸收截面较小的元素,而避免使用F等EUV吸收截面较大的元素。随后研究人员又发现,即使是对EUV光吸收较强的主体材料,还是“过于透明”了,以至于EUV光刻的灵敏度难以提高。因此,科研人员开始转向寻求吸收更强的主体材料,研发出了一系列基于金属元素的有机-无机杂化光刻胶。上海干膜光刻胶显示面板材料