KrF光刻时期,与ESCAP同期发展起来的还有具有低活化能的酸致脱保护基团的光刻胶,业界通称低活化能胶或低温胶。与ESCAP相比,低活化能胶无需高温后烘,曝光能量宽裕度较高,起初由日本的和光公司和信越公司开发,1993年,IBM公司的Lee等也研发了相同机理的光刻胶KRS系列,商品化版本由日本的JSR公司生产。其结构通常为缩醛基团部分保护的对羟基苯乙烯,反应机理如图12所示。2004年,IBM公司的Wallraff等利用电子束光刻比较了KRS光刻胶和ESCAP在50nm线宽以下的光刻性能,预示了其在EUV光刻中应用的可能性。半导体光刻胶的涂敷方法主要是旋转涂胶法,具体可以分为静态旋转法和动态喷洒法。KrF光刻胶其他助剂
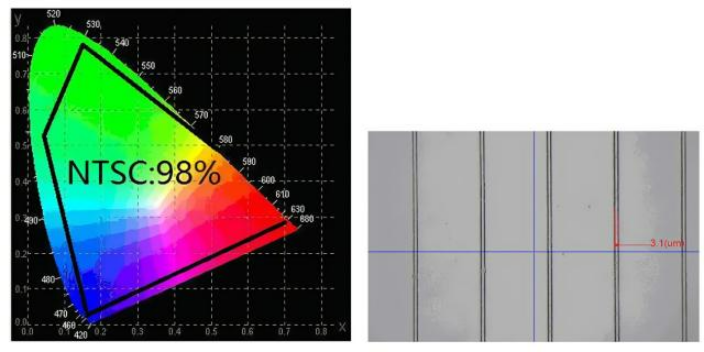
与金属纳米颗粒和纳米簇不同,金属配合物光刻胶中金属元素含量较低,通常情况下每个光刻胶分子内只有一个或几个金属原子。能够作为纳米颗粒和纳米簇配体的分子比较少,可修饰位点较少;而金属原子的配体种类较多,且容易连接活性基团,因此金属配合物光刻胶的设计更为灵活。但是,由于金属原子含量低,所以金属配合物对EUV光的吸收能力、抗刻蚀能力有可能弱于金属纳米颗粒和纳米簇光刻胶。目前已有多种金属元素的配合物被用于光刻胶,如铋、锑、锌、碲、铂、钯、钴、铁和铬等。上海i线光刻胶其他助剂按曝光波长可分为紫外光刻胶、深紫外光刻胶、极紫外光刻胶、电子束光刻胶、离子束光刻胶、X射线光刻胶等。

2005 年起,Gonsalves 课题组将阳离子基团(硫鎓盐等)修饰的甲基丙烯酸酯与其他光刻胶单体共聚,制备了一系列侧基连接光致产酸剂的光刻胶,聚合物中金刚烷基团的引入可以有效提升抗刻蚀性。这类材料与主体材料和产酸剂简单共混的配方相比,呈现出更高的灵敏度和对比度。2009年起,Thackeray等则将阴离子基团连接在高分子主链上,通过EUV曝光可以得到的光刻图形分辨率为22nm光刻图形,其对应的灵敏度和线边缘粗糙度分别为12mJ·cm−2和4.2nm。2011年,日本富士胶片的Tamaoki等也报道了一系列对羟基苯乙烯型主链键合光致产酸剂的高分子光刻胶,并研究了不同产酸剂基团、高分子组成对分辨率、灵敏度和粗糙度的影响,最高分辨率可达17.5nm。
尽管HSQ可以实现较好的EUV光刻图案,且具有较高的抗刻蚀性能,但HSQ较低的灵敏度无法满足EUV光刻的需求,且价格非常昂贵,难以用于商用的EUV光刻工艺中。另外,尽管HSQ中Si含量很高,但由于O含量也很高,所以HSQ并未展现含Si光刻胶对EUV光透光性的优势,未能呈现较高的对比度。因此,研发人员将目光转向侧基修饰的高分子光刻胶。使用含硅、含硼单元代替高分子光刻胶原本的功能性含氧侧基,既可有效降低光刻胶对EUV光的吸收,又有助于提高对比度,也可提高抗刻蚀性。光刻胶的组成部分包括:光引发剂(包括光增感剂、光致产酸剂)、光刻胶树脂、单体、溶剂和其他助剂。

中国在光刻胶领域十分不利,虽然G线/I线光刻胶已经基本实现进口替代,但高级别光刻胶依然严重依赖进口。KrF/ArF光刻胶自给率不足5%,EUV光刻胶还只是“星星之火”。国产KrF光刻胶已经逐步实现国产替代并正在放量,ArF光刻胶也在逐步验证并实现销售当中,国产光刻胶已经驶入了快车道。随着下游产能的快速增长,国产KrF/ArF光刻胶的需求将会持续提升。众所周知,在半导体装置的制造过程中,用于各种电路的无缝电气连接金属布线随着半导体产品的高集成化、高速化,越来越要求以较小的线宽制作。因此,选择合适的光刻胶是非常重要的,随着金属布线的线宽变小,不单大功率和低压力被用作金属布线形成的蚀刻方法,根据所用光刻胶的特点,去除蚀刻进程中产生的聚合物和光刻胶是非常重要的。光刻胶是一大类具有光敏化学作用的高分子聚合物材料,是转移紫外曝光或电子束曝照图案的媒介。江苏黑色光刻胶印刷电路板
光刻胶又称光致抗蚀剂,是一种对光敏感的混合液体。KrF光刻胶其他助剂
荷兰光刻研究中心的Castellanos课题组采用三氟乙酸配体和甲基丙烯酸配体,制备了一种锌氧纳米簇光刻胶Zn(MA)(TFA)。由于锌原子和三氟乙酸氟原子对 EUV 光都有较强的吸收能力,而甲基丙烯酸配体可通过光照后的双键聚合和交联反应进一步增强曝光前后的溶解度差异。这一配体在自然环境下的稳定性不好,空气中的水汽和自然光都会使甲基丙烯酸配体自发聚合;但在真空环境下则可稳定存在。不过这种纳米颗粒只可获得30nm线宽的光刻图案,曝光剂量为37mJ·cm−2,且制备的批次稳定性较差,距离实际应用还有一段距离。KrF光刻胶其他助剂